东京电子TEL JIN系列是日本东京电子(Tokyo Electron Limited, TEL)开发的干法等离子体刻蚀系统,主要面向300mm晶圆先进制程,涵盖逻辑芯片、存储芯片及化合物半导体制造中的介质刻蚀、金属刻蚀和硅刻蚀工艺。作为TEL中端主力机型,JIN系列包括SCCM JIN和Telius SCCM JIN等子型号,采用模块化架构设计,支持多腔室并行处理,平衡了工艺精度与生产效率,2024年全球市场份额约8%,主要客户包括台积电、三星和英特尔。
四分区RF源系统:13.56MHz射频电源(功率0-3000W),通过独立控制四个区域的功率分布,实现晶圆面内刻蚀均匀性<±3%(1σ)
动态匹配网络:实时调节阻抗匹配,确保等离子体密度稳定性(波动<2%)
先进气体注入:采用 showerhead 气体分配设计,支持6路工艺气体独立控制(MFC精度±0.5% FS)
材质选择:腔室主体采用铝阳极氧化处理,内衬Y₂O₃涂层,降低颗粒污染(<0.1 defects/cm²)
温度控制:基座温度范围-20°C~400°C(控温精度±1°C),支持电加热与液氮冷却双模式
真空系统:涡轮分子泵+机械泵组合,极限真空<5×10⁻⁷ Torr,抽气时间<30秒(从大气压到10mTorr)
实时监控:集成OES(光学发射光谱)终点检测,刻蚀终点判断精度±1%
远程诊断:支持SECS/GEM协议,可实现工艺参数追溯与远程故障诊断
晶圆传输:采用双臂机器人,传输时间<15秒/片,支持FOUP/SMIF盒式传输
| 指标 | SCCM JIN | Telius SCCM JIN |
|---|
| 晶圆尺寸 | 300mm(兼容200mm) | 300mm |
| 反应腔数量 | 2-4个(双腔室模块) | 4-8个(四腔室模块) |
| 刻蚀速率(SiO₂) | 500-2000 Å/min | 800-3000 Å/min |
| 选择比(SiO₂/PR) | >50:1 | >80:1 |
| 片内均匀性 | <±3%(1σ) | <±2.5%(1σ) |
| 生产率 | 80-120片/小时 | 150-200片/小时 |
FEOL工艺:多晶硅栅极刻蚀(线宽控制±0.5nm)、STI浅沟槽隔离刻蚀
BEOL工艺:低k介质刻蚀(介电常数k<2.5)、铜互连层通孔刻蚀(深宽比>10:1)
先进节点:支持5nm GAA FET器件的纳米片刻蚀,侧壁粗糙度<1nm RMS
3D NAND:阶梯刻蚀(>100层堆叠),垂直度偏差<0.5°,关键尺寸均匀性<±3%
DRAM:存储电容沟槽刻蚀(深度>5μm,直径<50nm),底部圆角<5nm
新兴存储:支持MRAM的MgO隧道势垒刻蚀,选择性>100:1(对TaN电极)
工艺灵活性:支持氟基(CF₄、SF₆)、氯基(Cl₂、BCl₃)、溴基(HBr)等多类化学体系,可快速切换刻蚀模式
成本效益:单腔室月产能>15,000片,单位晶圆处理成本较竞品低12%
良率提升:采用专利的侧壁保护技术,刻蚀剖面垂直度>89°,减少后续工艺缺陷
主要竞品:应用材料Endura®刻蚀系统、泛林半导体Kiyo™系列
差异化优势:在3D NAND阶梯刻蚀领域市占率超40%,较泛林Kiyo™生产率高15%
发展趋势:下一代JIN+机型将集成AI工艺优化模块,预计良率提升2-3%
高深宽比刻蚀:对于>50:1的通孔刻蚀,底部残留物控制难度增加
材料兼容性:对新兴High-κ材料(如HfO₂)刻蚀选择性需进一步优化
能耗问题:单台设备功耗约25kW,高于行业平均水平10%
等离子体源升级:开发新型ICP源,等离子体密度提升至1×10¹² ions/cm³
绿色制造:采用低Global Warming Potential(GWP)气体,降低碳排放30%
原子级控制:引入ALD辅助刻蚀技术,实现Å级精度的厚度控制
东京电子官方网站 - 刻蚀设备产品线
SEMI 2024年半导体设备市场报告
台积电3nm工艺设备选型白皮书(2024)
TEL Telius SCCM JIN技术规格书
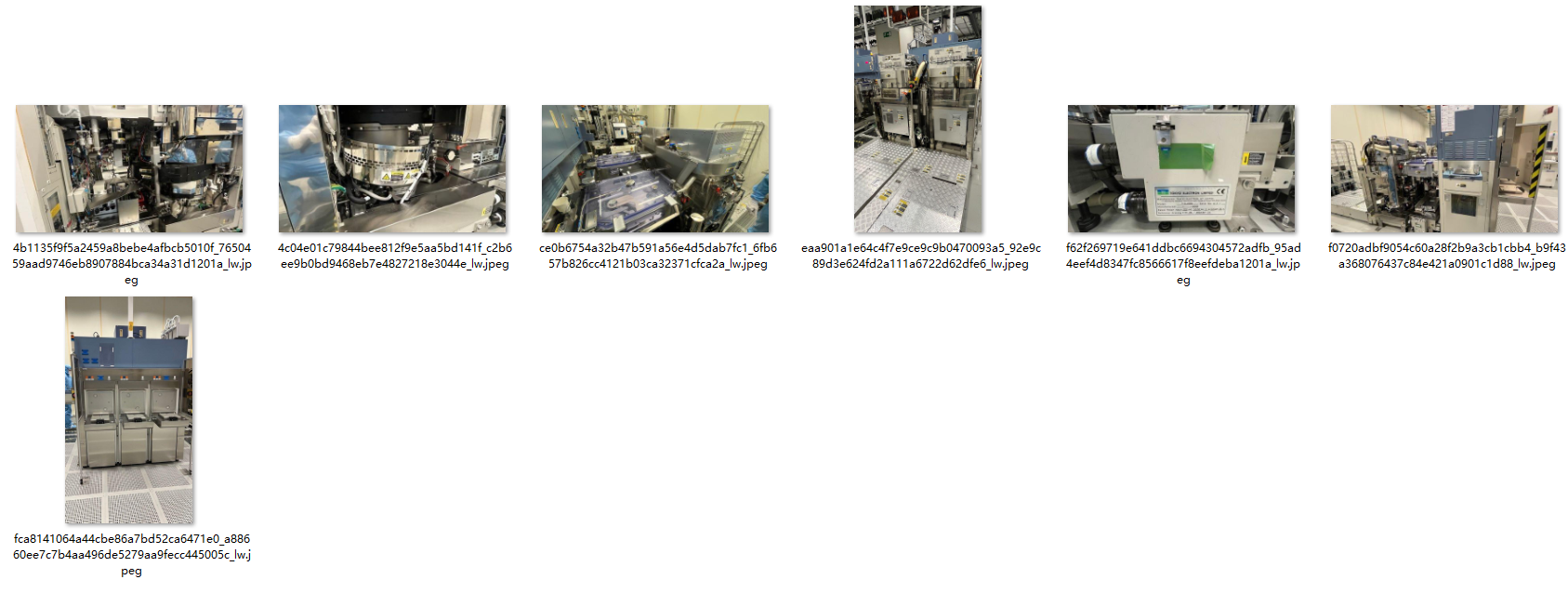
我们专注于为半导体设备公司提供一站式解决方案,涵盖核心半导体模块制造、精密半导体机架及关键半导体零部件的设计与制造。