Centura MCVD(Metal Chemical Vapor Deposition)是应用材料公司(Applied Materials)开发的金属化学气相沉积系统,专为200mm(8英寸)晶圆的金属薄膜沉积设计。作为Centura平台的重要组成部分,该设备采用等离子体增强化学气相沉积(PECVD) 技术,主要用于半导体制造中的钛(Ti)、氮化钛(TiN)等金属及化合物薄膜沉积,是铜互连工艺中扩散阻挡层制备的关键设备。
技术代际:属于Centura平台第二代产品(2000年代初推出),替代早期Precision 5000系列,目前仍在28nm及以上成熟制程产线广泛应用。
市场份额:在200mm金属CVD设备市场占据约30%份额,主要竞争对手为东京电子(TEL)的SOKUDO TiN CVD系统。
典型客户:台积电(28nm/40nm逻辑产线)、联电(55nm BCD工艺)、中芯国际(40nm低功耗芯片产线)。
Centura MCVD采用模块化Cluster架构,可配置4个工艺腔室和2个负载锁定腔(Load Lock),实现以下功能集成:
| 腔室类型 | 主要功能 | 关键组件 |
|---|
| Ti/TiN沉积腔 | 金属薄膜沉积 | 射频等离子体源(13.56MHz)、喷淋头 |
| 预清洗腔 | 等离子体表面活化 | NF₃/Ar等离子体源 |
| degas腔 | 晶圆烘烤除气 | 红外加热基座(最高450°C) |
| 传输模块 | 真空环境下晶圆搬运 | 磁耦合机械臂 |
这种设计实现了晶圆在真空环境下的全流程处理,避免大气暴露导致的污染,同时通过并行处理将生产率提升至60片/小时(200mm晶圆)。
前驱体输送系统:采用液体源输送(LDS)技术,精确控制TiCl₄等金属有机化合物的流量(精度±1%),配合气化器(Vaporizer)实现气态前驱体的稳定供给。
等离子体生成:双频RF电源(2MHz/13.56MHz)产生高密度等离子体(10¹¹ ions/cm³),促进前驱体分解和表面反应。
温度控制:晶圆基座采用电阻加热,控温范围50-450°C,精度±1°C,确保薄膜结晶质量。
| 参数项 | 典型值 | 行业对比优势 |
|---|
| 晶圆尺寸兼容性 | 200mm(兼容150mm) | 成熟制程主力规格 |
| 沉积材料范围 | Ti, TiN, Ta, TaN | 覆盖金属化全流程需求 |
| 薄膜厚度范围 | 50Å - 2μm | 适配不同互连层厚度要求 |
| 片内均匀性 | <±3%(3σ) | 优于TEL SOKUDO(±4%) |
| 电阻率(TiN薄膜) | <200 μΩ·cm | 接近物理气相沉积(PVD)水平 |
| 台阶覆盖率 | >90%(深宽比5:1) | 满足3D NAND高深宽比结构需求 |
设备尺寸:约4.5m × 3.8m × 2.5m(含维护空间)
功耗:约45kW(满载运行)
真空度:沉积腔室<1×10⁻⁵ Torr(极限真空)
气体需求:TiCl₄(纯度99.999%)、NH₃、N₂O、Ar等
在28nm FinFET工艺中,Centura MCVD用于以下关键步骤:
Ti阻挡层沉积:采用TiCl₄ + H₂反应,沉积5-10nm厚Ti薄膜,防止Cu扩散至SiO₂介质层。
TiN扩散阻挡层:通过TiCl₄ + NH₃等离子体反应,沉积8-15nm TiN,电阻率<200 μΩ·cm。
工艺整合:与后续PVD Cu种子层沉积形成"阻挡层-种子层"双层结构,确保电镀Cu的无孔洞填充。
针对128层3D NAND字线电极制备:
在SiC MOSFET制造中:
Centura MCVD主要与东京电子(TEL)的SOKUDO TiN CVD系统竞争,两者技术对比:
| 竞争维度 | AMAT Centura MCVD | TEL SOKUDO |
|---|
| 技术节点覆盖 | 55nm - 0.18μm | 28nm - 0.13μm |
| 拥有成本(CoO) | 低10-15% | 工艺稳定性更优 |
| 薄膜均匀性 | 片内±3% | 片内±2.5% |
Centura MCVD的核心优势在于性价比和成熟制程兼容性,尤其在200mm产线中占据主导地位。
原子层沉积(ALD)融合:应用材料已推出Centura iSprint ALD/CVD混合系统,将TiN沉积厚度控制精度提升至0.1nm级别,适配7nm及以下节点。
绿色制造技术:开发低毒性前驱体(如有机钛化合物)替代TiCl₄,减少腐蚀性废气排放。
AI工艺优化:通过大数据分析建立沉积参数与薄膜性能的关联模型,将新工艺开发周期缩短30%。
先进制程适配瓶颈:在14nm及以下节点,Cu互连电阻升高问题凸显,传统TiN阻挡层需被更薄的Ru或Co层替代,Centura MCVD需升级ALD模块。
大尺寸晶圆兼容性:当前设备仅支持200mm晶圆,无法满足300mm先进制程产线需求,需更换为Endura平台。
维护复杂度:金属前驱体易导致腔室污染,平均维护间隔(MTBM)仅约300小时,高于行业平均的450小时。
应用材料官网 - Centura CVD产品线
SEMI《2024年半导体设备市场报告》
台积电《28nm铜互连工艺白皮书》
Applied Materials, "TiN Barrier Deposition for Advanced Interconnects", 2018
中芯国际《成熟制程金属化工艺指南》
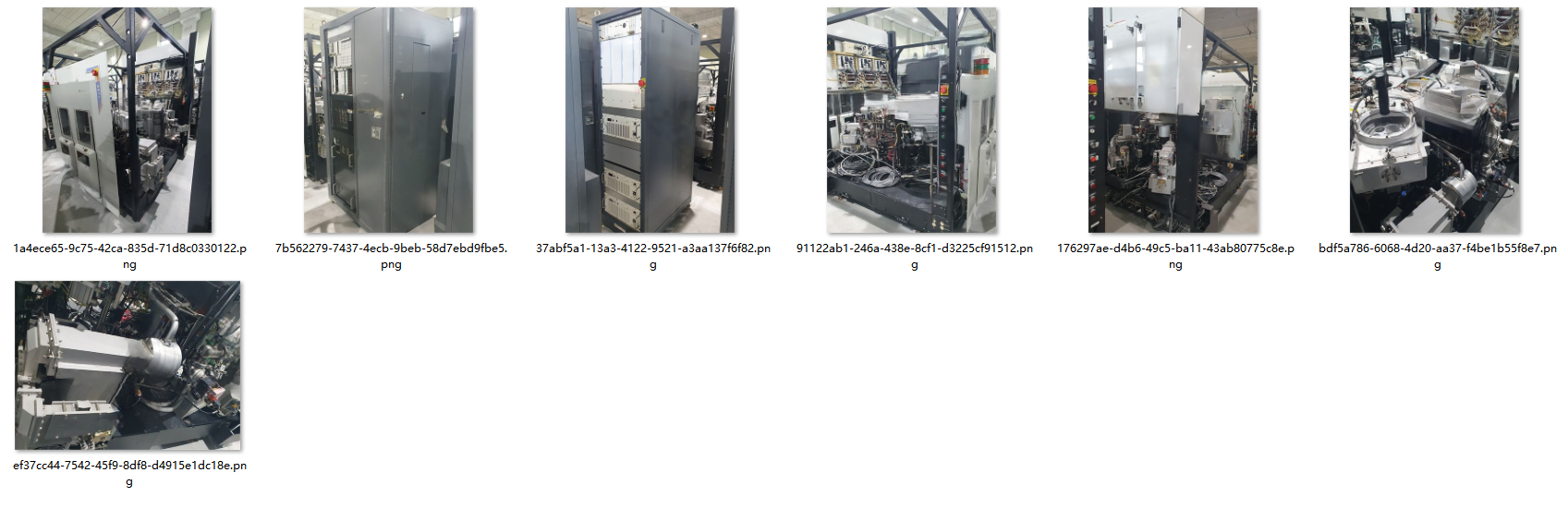
我们专注于为半导体设备公司提供一站式解决方案,涵盖核心半导体模块制造、精密半导体机架及关键半导体零部件的设计与制造。